
Полупроводниковые приборы с широкой запрещенной зоной давно нашли широкое применение в современной силовой электронике. Пионером стал карбид кремния (SiC), затем – нитрид галлия (GaN). Основные параметры этих полупроводников представлены в таблице 1. Структура SiC FET, GaN FET и традиционного кремниевого Si MOSFET схематично показана на рисунке 1.
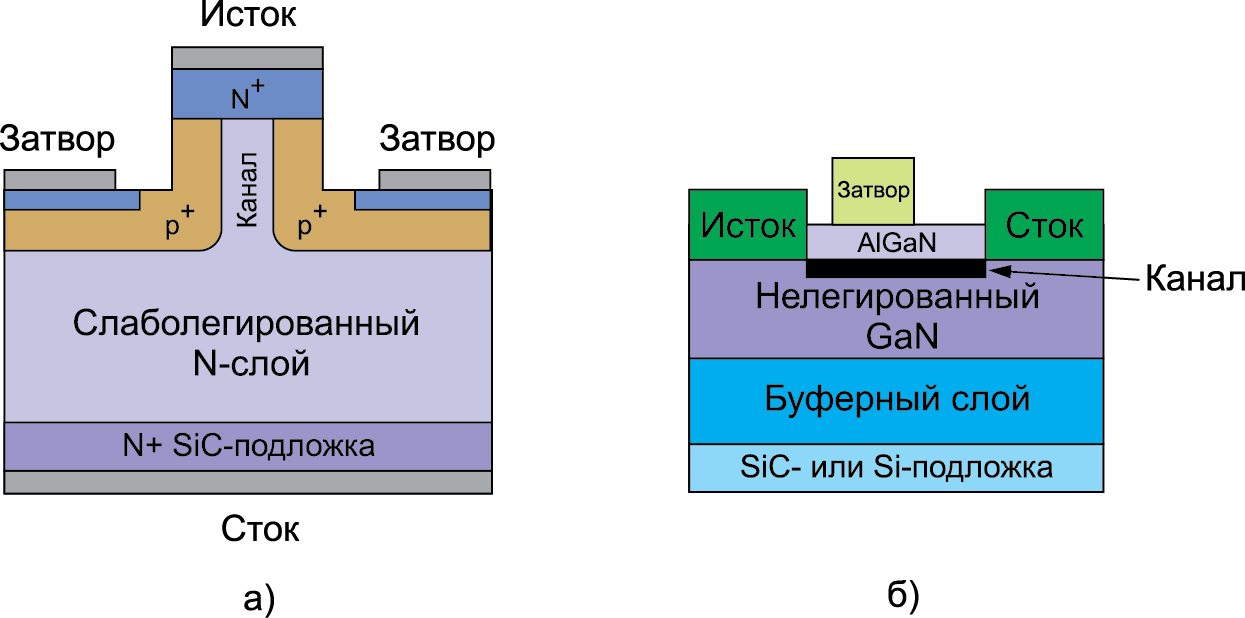
Таблица 1. Основные параметры полупроводников
|
Электрические параметры |
Si
|
SiC
|
GaN
|
|---|---|---|---|
|
Ширина запрещенной зоны, эВ |
1,1 |
3,26 |
3,44 |
|
Коэффициент теплопроводности, Вт/(см∙К) |
1,5 |
3,7 |
1,3 |
|
Подвижность электронов, см2/(В∙с) |
1300 |
900 |
900–1200 |
|
Максимальная скорость движения электронов, 106 см/с |
10 |
22 |
25 |
|
Критическая напряженность электрического поля, 106 В/см |
0,3 |
3 |
3,5 |
Как видно из таблицы, основное отличие карбида кремния SiC и нитрида галлия GaN от традиционного кремния Si заключается в ширине запрещенной зоны и, соответственно, в критической напряженности электрического поля. Именно эти отличия и определяют главное преимущество SiC и GaN – они могут работать с большим максимально допустимым напряжением. На сегодняшний день этот параметр полевых GaN FET составляет 650 В, а их собратьев SiC FET – 1700 В. Последним мы и уделим основное внимание в нашем коротком обзоре.
Высоковольтные SiC FET, вторгаясь во владения 900-, 1200- и 1700-В IGBT, в ряде приложений выигрывают конкурентную битву благодаря заметно меньшим потерям и большей рабочей частоте. Вкупе оба перечисленных преимущества позволяют уменьшить габариты силового блока и упростить решение проблем с охлаждением.
Прежде чем привести сравнительные характеристики, заметим, что производятся не только SiC FET, но и высоковольтные SiC-диоды с барьером Шоттки (SBD). SiC SBD отличаются заметно меньшим временем восстановления обратного сопротивления, за счет чего позволяют существенно снизить потери в силовом каскаде. На рисунке 2 показан процесс выключения в модуле CM600DU-24NFH из 2 Si IGBT с двумя антипараллельными Si-диодами и аналогичный процесс в гибридном (из SiC- и Si-приборов) модуле CMH600DU-24NFH из 2 Si IGBT с антипараллельными SiC-диодами, оба модуля производятся компанией Mitsubishi.
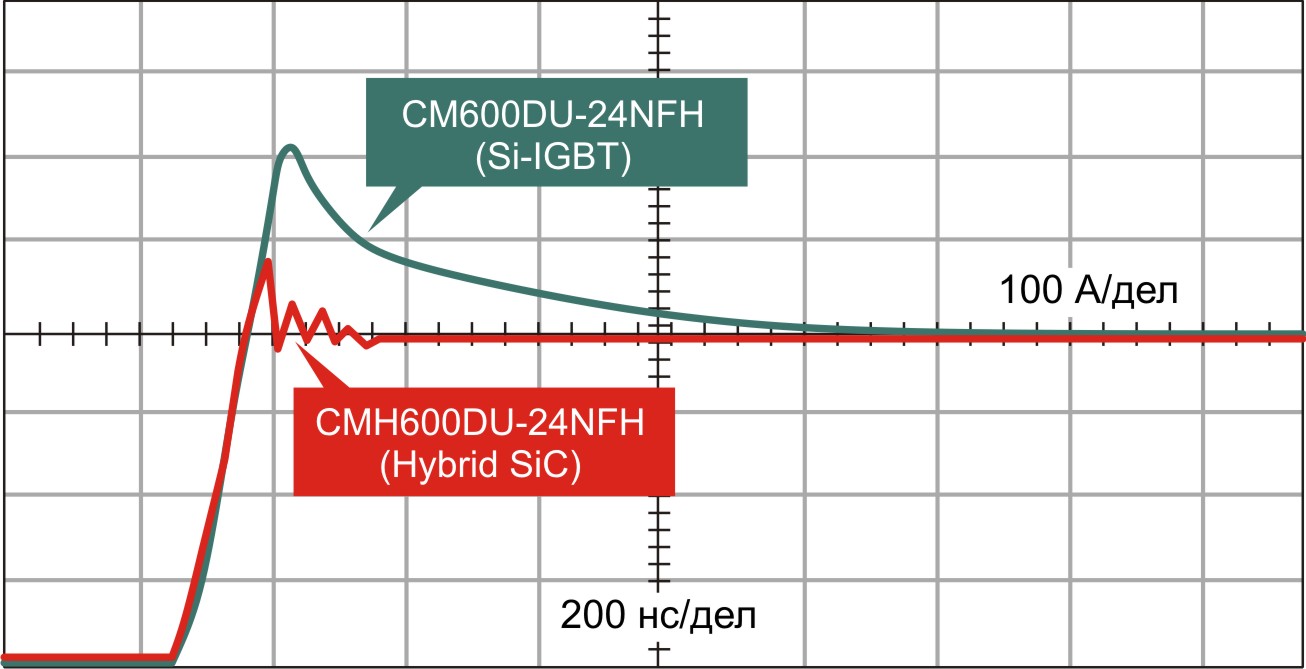
Как видно из рисунка, обратный ток в модуле с двумя антипараллельными Si-диодами более чем вдвое превышает обратный ток в модуле с антипараллельными SiC-диодами и процесс выключения в первом случае длится заметно дольше. Разумеется, столь различный процесс восстановления обратного сопротивления диодов сказался и на потерях.
Таблица 2. Сравнительные характеристики сборок CMH600DU-24NFH и FMF600DXZ-24V
|
Параметр |
Гибридная сборка CMH600DU-24NFH |
Full SiC сборка FMF600DXZ-24V |
|---|---|---|
|
Максимальное напряжение, В |
1200 |
1200 |
|
Максимальный длительный ток, А |
600 |
600 |
|
Напряжение насыщения коллектор–эмиттер VCE, В |
5,0 при VGE = 10 В, IC= 600 А, Т = 125°С |
– |
|
Сопротивление открытого канала RDS(ON), мОм |
– |
3,0 при VGS = 15 В, IC = 600 А, Т = 125°С |
|
Суммарный заряд затвора QG, нКл |
2700 |
1463 |
|
Выходная емкость, нФ |
8 |
37 |
|
Время задержки на включение, нс |
400 (макс.) |
170 (тип.) |
|
Время нарастания, нс |
120 (макс.) |
70 (тип.) |
|
Время задержки на включение, нс |
700 (макс.) |
350 (тип.) |
|
Время спада, нс |
150 (макс.) |
40 (тип.) |
Теперь сравним характеристики Si IGBT и SiC FET. С этой целью выберем 1200-В гибридный модуль CMH600DU-24NFH и 1200-В модуль MF600DXZ-24V, состоящий из SiC FET и SiC SBD – модуль Full SiC. В таблице 2 приведены некоторые сравнительные параметры обоих модулей, которые характеризуют их основные отличия. Видно, что модульl SiC FMF600DXZ-24V позволяет заметно уменьшить потери на проводимость и коммутационные потери. В некоторых случаях они сокращаются на 70%. Кроме того, меньший суммарный заряд затвора позволяет уменьшить и выходную мощность драйвера затвора PGD, которая определяется из соотношения:
PGD = QG ∙ VGS ∙ fSW,
где VGS – выходное напряжение драйвера; fSW – частота коммутации.
Но, как известно, всякая палка – о двух концах: кроме достоинств, у SiC FET имеются и недостатки, главным из которых является более высокая стоимость, обусловленная большей сложностью тестирования и производства. Основная проблема заключается в том, что на границе разделения SiC с оксидом SiO2 уменьшается подвижность носителей. Следовательно, для того чтобы не снижать динамические параметры, приходится увеличить напряженность электрического поля до 4–5 МВ/см (в Si MOSFET она не превышает 3 МВ/см).
Еще одним недостатком, вернее особенностью, SiC FET является более высокая плотность дефектов подзатворного оксида. Вкупе перечисленные обстоятельства снижают надежность SiC FET, т.к. при повышении напряженности электрического поля из-за высокой плотности дефектов может произойти электрический пробой оксида. Исключить пробой можно за счет увеличения толщины оксида. При этом снижается напряженность электрического поля, и, к сожалению, возрастает сопротивление открытого канала RDS(ON).
Таким образом, производителю приходится усложнить технологии производства и на заключительном этапе обработки материала постараться свести к минимуму число дефектов оксида, а также выполнить тестирование с целью отбраковки непригодных экземпляров. Все перечисленное не может не сказаться на стоимости полупроводникового прибора. Увы, но даже при самой совершенной технологии приходится идти на компромисс – увеличивать толщину оксида и увеличить сопротивление. Сравнивая разные SiC FET при прочих равных условиях, по величине RDS(ON) можно косвенно судить о качестве производственного процесса.
В силу указанных выше особенностей, для реализации всех преимуществ SiC FET необходимо выбрать производителей, имеющих полный цикл производства, начиная с выращивания кристаллов. Только в этом случае обеспечивается оптимальная технология производства и тестирование компонентов. В качестве примера можно привести компании Mitsubishi и Infineon, отвечающие все требованиям. Причем наиболее широкой производственной линейкой гибридных и полностью SiC модулей располагает компания Mitsubishi.
Несовершенство технологии производства может вызвать эффект биполярной деградации, который проявляется при использовании внутреннего диода SiC FET. Суть этого эффекта заключается в уменьшении активной зоны и, как следствие, в увеличении сопротивления RDS(ON) и прямого падения напряжения на диоде. Если же технология отлажена и число дефектов невелико, параметры прибора не выйдут за указанные в документации пределы.
Несколько слов стоит сказать и о тепловых характеристиках. Максимально допустимая температура SiC FET составляет 175°С, в то время как у Si MOSFET она не превышает 150°С. Это важное преимущество SiC FET, но для его реализации также потребуются дополнительные затраты. Дело в том, что высокие динамические показатели достигаются при уменьшении размера кристалла, что ведет к ухудшению теплоотдачи и, следовательно, может вызвать рост температуры кристалла.
Для ее уменьшения необходимо снизить тепловое сопротивление RθJC переход–корпус, отказавшись от экономичных паяных соединений на основе Pb95.5Ag2.5Sn2.0, и использовать более дорогую серебряную пасту с большей теплопроводностью. Все перечисленное не может не сказаться на стоимости полупроводникового прибора.
Еще одним отличием SiC FET от Si MOSFET является выходная характеристика приборов. На рисунке 3 показаны выходные характеристики SiC FET при разном напряжении управления затвор–сток VGS и выходная характеристика Si MOSFET (красная линия). Нетрудно заметить, что выходные характеристики SiC FET, в отличие от характеристик Si MOSFET, не имеют явно выраженной точки перегиба при переходе из линейного режима в режим насыщения. Следовательно, по мере увеличения управляющего напряжения VGS сопротивление открытого канала монотонно уменьшается.
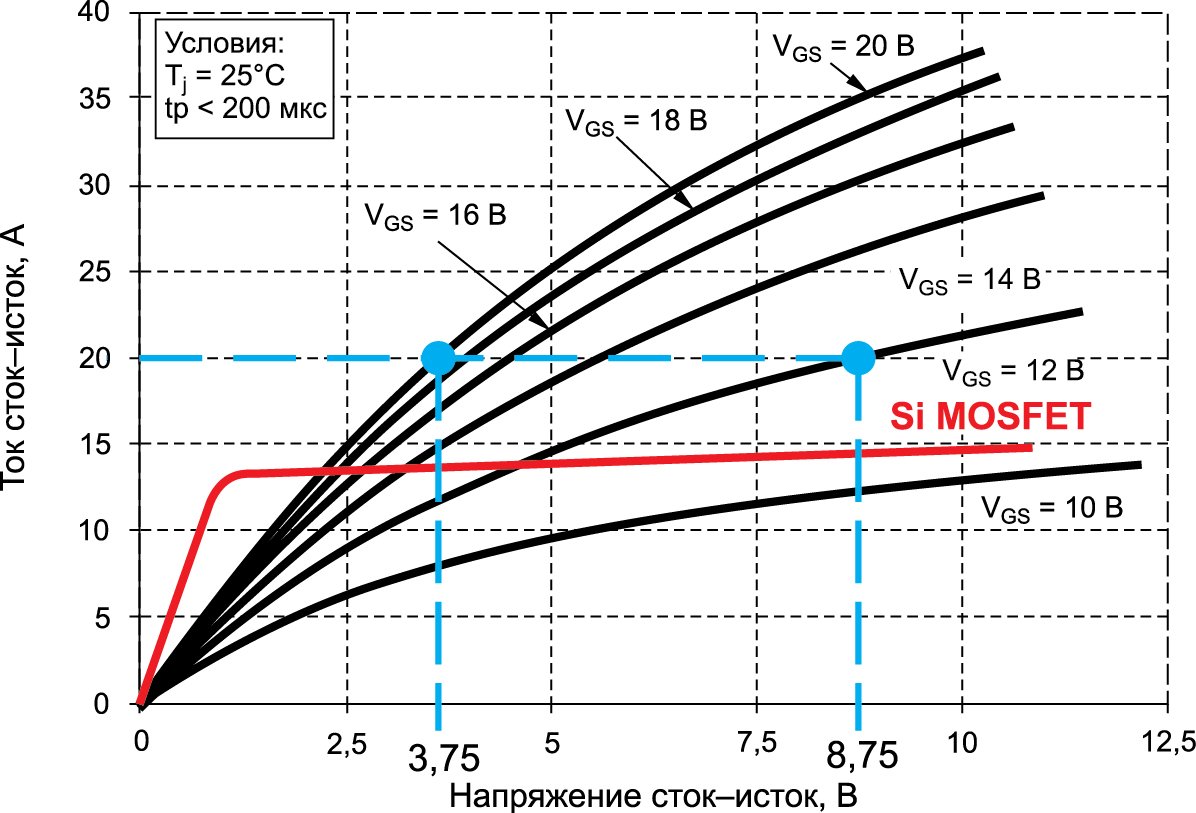
Из различия характеристик следуют два основных вывода. Во-первых, выходное напряжение драйвера затвора SiC FET необходимо увеличить до 18–20 В. Во-вторых, схема защиты SiC FET от короткого замыкания должна быть более быстродействующей, т.к. в режиме насыщения ток короткого замыкания слабо ограничивается выходной характеристикой и может достичь очень высоких значений.
Напомним, что при коммутации обычно возникает колебательный переходный процесс из-за индуктивности и емкости проводников, особенно явно выраженный при крутых фронтах изменения тока и напряжения. Во избежание ложных срабатываний, защита от токов КЗ пропускает этот интервал длительностью 1–3 мкс. SiC FET подобный метод может не подойти, т.к. за это время ток короткого замыкания достигает критической величины. Таким образом, очень важна тщательная проработка топологии силового каскада для сведения к минимуму длительности переходных процессов. Желательно использовать сборку, в которой силовой ключ объединен с драйвером затвора и длина проводников, а, следовательно, и их паразитные параметры минимальны.
Иначе проявляется в SiC FET и эффект Миллера. На рисунке 4 показана зависимость напряжения затвор–исток от заряда затвора. Из рисунка видно, что заряд затвора снижается до нуля при отрицательно напряжении VGS. Следовательно, выходное напряжение драйвера затвора SiC FET при запирании силового ключа также должно быть отрицательным и находиться в пределах не больше –2 В.
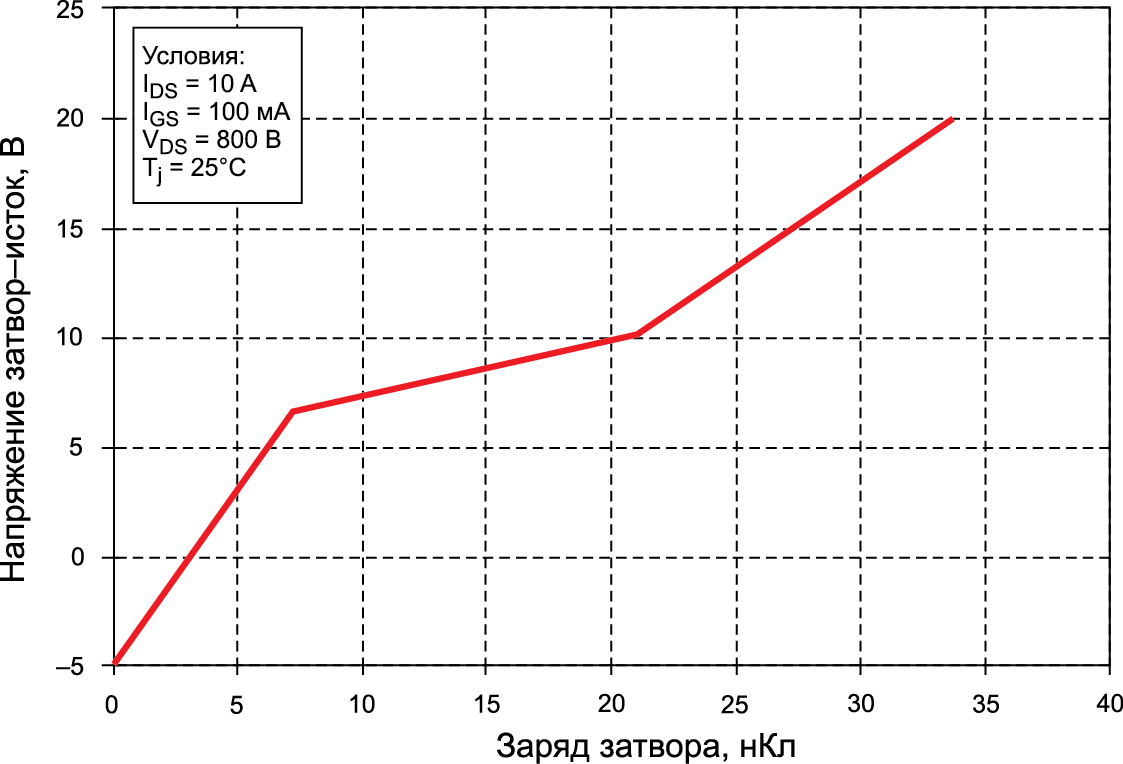
Выше мы уделили основное внимание SiC FET из-за того, что они получили большее распространение к настоящему времени на отечественном рынке и их можно рассматривать как замену Si IGBT, которых они уверенно обходят по многим параметрам кроме стоимости. Практически те же преимущества имеются и у ключей GaN FET, но за счет большей подвижности носителей их максимальная частота коммутации выше, чем у SiC FET, а максимально допустимое напряжение пока достигает 650 В. Таким образом, нельзя говорить о конкуренции GaN FET и SiC FET. Последние, в основном, производятся на напряжения 900 и 1200 В, а с недавнего времени – и на 1700 В.
Невозможно провести четкую границу между областями применения рассмотренных полупроводниковых приборов. К тому же, технологии продолжают совершенствоваться, и эти границы меняются. Для примера на рисунке 5 показаны области применения Si IGBT, Si MOSFET, GaN FET и SiC FET. Поскольку на рисунке отражено мнение компании, производящей GaN FET, его едва ли можно считать беспристрастным.
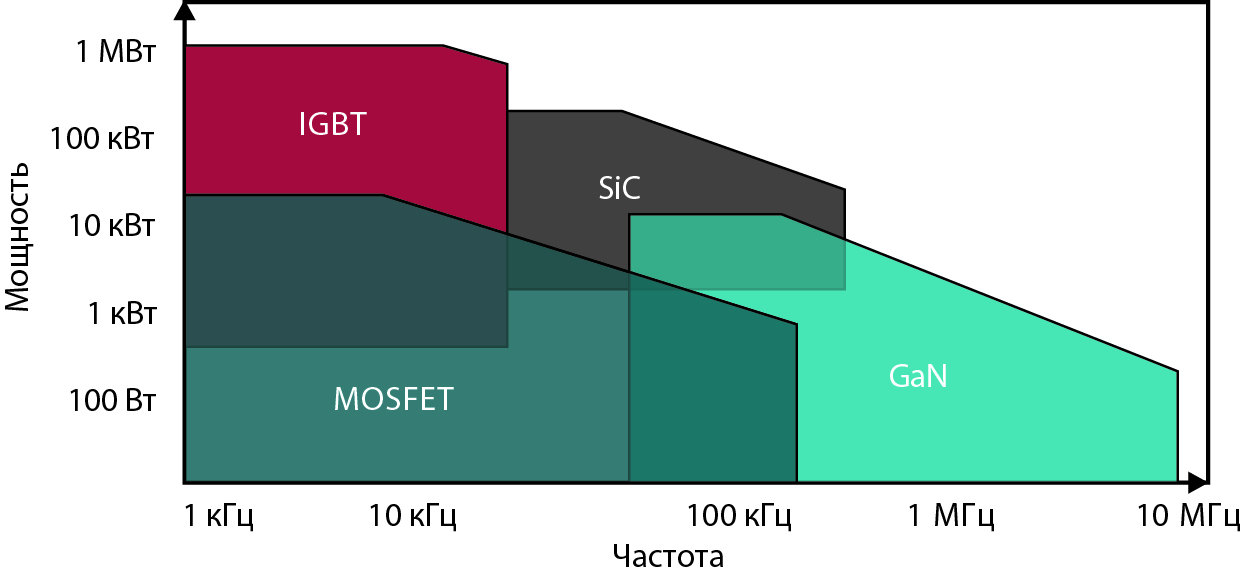
В повседневной практике вопрос о применении того или иного компонента определяется требованиями конкретного проекта. Например, в электроприводе скорость изменения фронтов напряжения ограничивается величиной 5 В/нс, в то время как у ключей GaN FET и SiC FET эта скорость может достигать 150–200 В/нс. Следовательно, в случае чувствительных к цене приложений по управлению электроприводом лучше подойдут недорогие Si IGBT. Если же главными требованиями являются энергоэффективность и массогабаритные показатели, предпочтение отдается GaN FET или SiC FET в зависимости от рабочего напряжения.